第44回 市村産業賞 貢献賞 -05
半導体メモリの大幅大容量化を実現するフォトマスク現像技術
| 技術開発者 | 株式会社 東芝 研究開発センター 研究主務 桜井 秀昭 |
| 技術開発者 | 同社 同センター グループ長 伊藤 正光 |
| 技術開発者 | 東京エレクトロン九州株式会社 開発部 主任技師 船越 秀朗 |
| 推薦 | 一般社団法人電気通信協会 |
開発業績の概要 |
|
パソコン、携帯電話などの半導体応用製品が急速な普及を遂げる中で、それらに用いられる半導体メモリ(NANDフラッシュメモリ)は年率約2倍の大容量化が求められ、メモリ設計上、年率約30%の回路パターンの微細化が求められてきた。回路パターンの微細化にはパターンの原版であるフォトマスクの高精度化が不可欠であるが、フォトマスクの現像工程で発生する寸法誤差が回路パターンの微細化、メモリの大容量化への高い障壁となっていた。 |
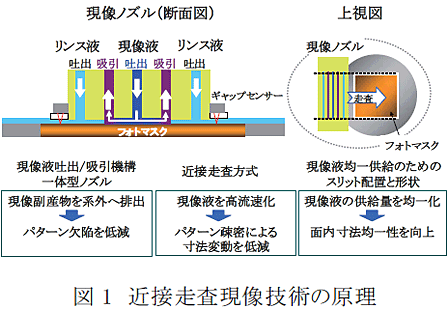 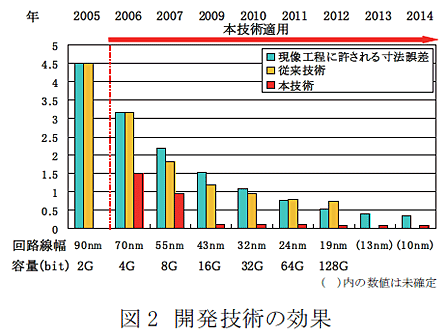 |















